PASSAGE L200
First Edgeless I/O 3D Co-Packaged Optics
Passage™ L200 eliminates the shoreline bottleneck. By stacking the photonic engine with the electronic IC, we deliver 32-64 Tbps of optical I/O per chip—enabling bandwidth densities 5-10x greater than conventional solutions.

Bandwidth
32-64
Tbps Optical I/O
Total I/O
200+
Tbps / Chip
Density
10x
vs Pluggables
Latency
Linear
Drive Architecture
Architecture
Breaking the Shoreline Constraint
The Challenge
Conventional chip I/O is confined to the die edges (“shoreline”). As die area scales (r²), perimeter scales only linearly (2πr), creating a bandwidth bottleneck. Chips exhaust edge space long before they exhaust compute capability.
The L200 Solution
Passage removes this constraint by vertically integrating the photonic IC (PIC) beneath the electronic IC (EIC). This allows SerDes and optical interfaces to be placed across the entire die surface, enabling bandwidth density that scales with silicon area rather than die perimeter.
Product Variants
Passage L200
32 Tbps Optical I/O
Optimized for next-generation XPUs requiring breakthrough bandwidth density. The standard for 3D co-packaged optics.
- 3D Vertical Integration
- Chip-on-Wafer (CoW)
- Detachable Fiber
Passage L200X
64 Tbps Optical I/O
Maximum-bandwidth variant for ultra-dense AI infrastructure. Doubles optical I/O for demanding workloads.
- 2x Bandwidth Density
- Same 3D Form Factor
- Extreme Scalability
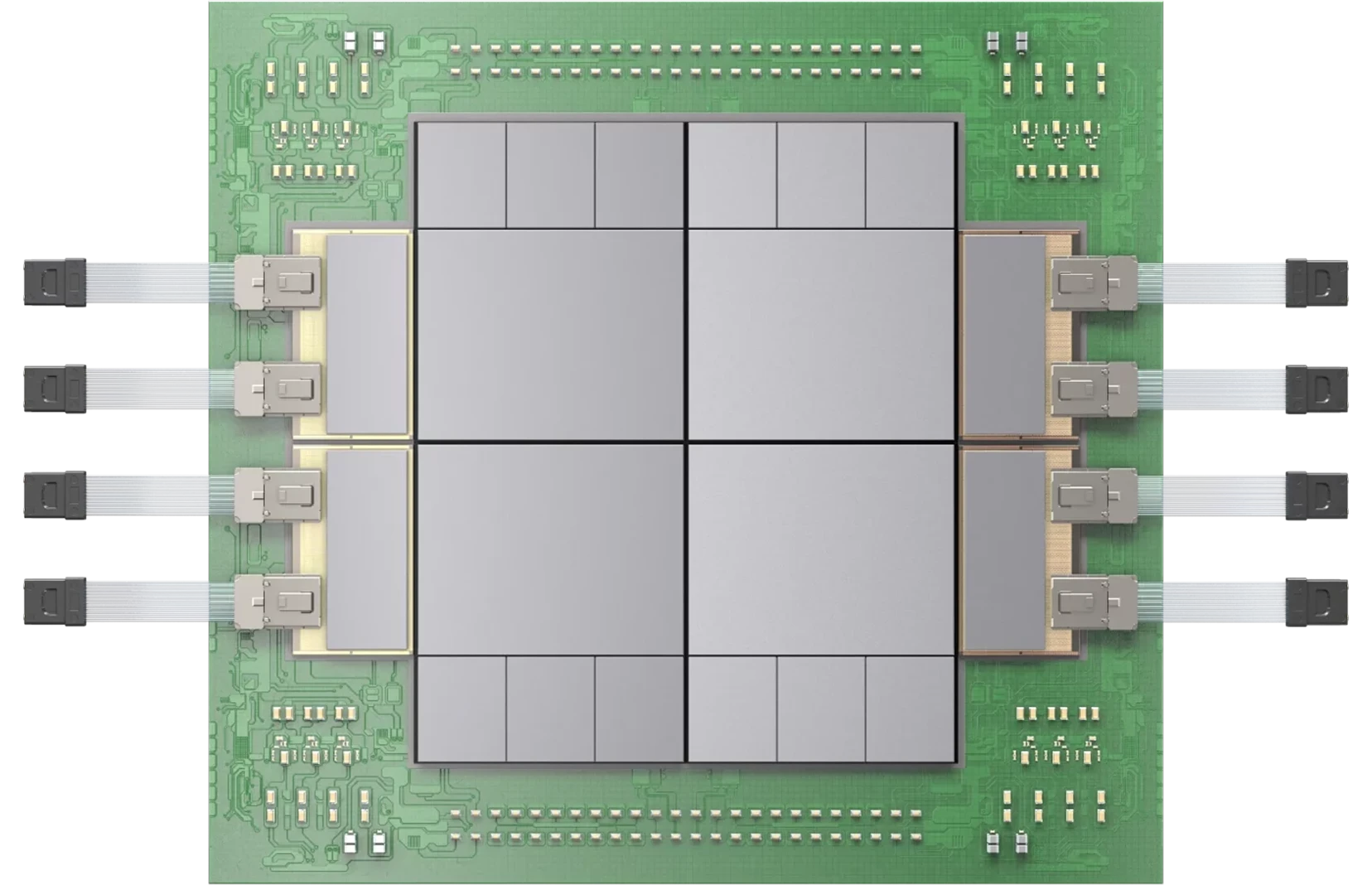
Technical Specifications
Ready to scale?
L200 design partnerships are open for 2026 roadmaps.